- 探討電平位移電路應(yīng)用于負電源的設(shè)計
- 設(shè)計電源電壓為8~-100V的電平位移電路
- 對高壓LDMOS進行優(yōu)化設(shè)計
本文設(shè)計了一種應(yīng)用于負電源的電平位移電路。實現(xiàn)從0~8V低壓邏輯輸入到8~-100V高壓驅(qū)動輸出的轉(zhuǎn)換。分析了該電路的結(jié)構(gòu)和工作原理。基于此電路結(jié)構(gòu)設(shè)計了滿足應(yīng)用要求的高壓薄膜SOI LDMOS器件。分析了器件的工作狀態(tài)以及耐壓機理,并利用工藝器件聯(lián)合仿真對器件的電學(xué)特性進行了優(yōu)化設(shè)計。
在柵驅(qū)動電路中需要電平位移電路來實現(xiàn)從低壓控制輸入到高壓驅(qū)動輸出的電平轉(zhuǎn)換。而在一些領(lǐng)域如SOC中的待機模式激活、ESD保護等需要能工作在負電源的電平位移電路。
SOI(Silicon-On-Insulator)技術(shù)以其高速、低功耗、高集成度、極小的寄生效應(yīng)以及良好的隔離等特點,在集成電路設(shè)計應(yīng)用中倍受青睞。
本文基于SOI高壓集成技術(shù)設(shè)計了電源電壓為8~-100V的電平位移電路,并對電路中的核心LDMOS器件進行了設(shè)計和模擬仿真優(yōu)化。
1 電路結(jié)構(gòu)
傳統(tǒng)正電源應(yīng)用的電平位移電路結(jié)構(gòu)如圖1(a)所示。L1、L2、L3是由邏輯電路部分產(chǎn)生的低壓時序控制信號,N1、N2、N3為高壓nLDMOS器件,P1、P2、P3為高壓平pLDMOS器件。由P1,P2和N1、N2構(gòu)成的電平位移單元將L1、L2的低壓邏輯信號轉(zhuǎn)變?yōu)榭梢钥刂芇3管的高壓電平,與L3一起控制由P3和N3組成的反向輸出級,從而實現(xiàn)從低壓邏輯信號到高壓驅(qū)動輸出的轉(zhuǎn)換。
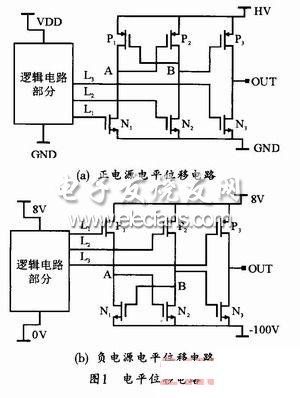
在正電源電平位移電路中,由于nLDMOS的源極為低壓,所以可以通過低壓邏輯部分來控制其開關(guān)狀態(tài),而源極為高壓的pLDMOS則通過電平位移來控制。當(dāng)高壓驅(qū)動電壓為8~-00V,低壓邏輯部分工作電壓為0~8V時,電平位移轉(zhuǎn)換部分的電壓分布本身沒有改變,但是在和低壓控制端接合時,與傳統(tǒng)的正電源相比電平發(fā)生了改變,就需要重新設(shè)計低壓邏輯的控制方式。此時,nLDMOS的源極為-100V電壓,顯然不能通過低壓邏輯控制部分的0~8V電壓來實現(xiàn)控制,而pLDMOS的源極為8V電源。因此采用了低壓邏輯輸出直接控制pLDMOS,而nLDMOS則通過電平位移來控制的方法,如圖1(b)所示。
2 器件設(shè)計及優(yōu)化
由于負電源供電的電平位移電路結(jié)構(gòu)的改變,應(yīng)用于正電源的常規(guī)nLDMOS和pLDMOS不能滿足該電路結(jié)構(gòu)要求。在正電源供電的電平位移電路中,由于pLDMOS的源端接高壓電源,其柵源需要承受高壓,所以pLDMOS采用了厚柵氧的結(jié)構(gòu),如圖2(a)所示。在使用負電源的電平位移電路結(jié)構(gòu)中(圖1(b)),pLDMOS的源端為邏輯高壓8V,柵端由低壓邏輯0~8V電壓控制,因此柵源不再承受高壓。但是nLDMOS的源端為負電源的最低電位,其柵源需要承受高壓,因此高壓nLDMOS需要采用厚柵氧結(jié)構(gòu),如圖2(b)所示。
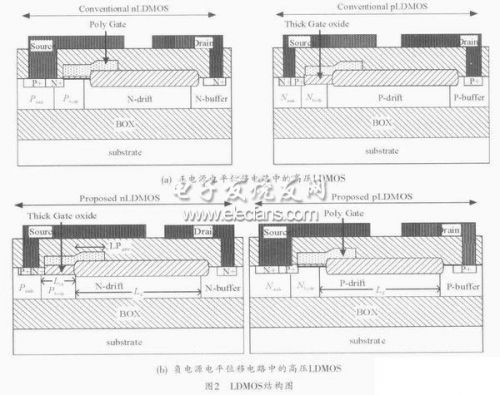
[page]

利用工藝器件聯(lián)合仿真,在傳統(tǒng)的正電源應(yīng)用的LDMOS基礎(chǔ)上對器件的結(jié)構(gòu)參數(shù)進行優(yōu)化設(shè)計。圖4(a)為pLDMOS在漂移區(qū)注入劑量Nd=7 e12cm-2時關(guān)態(tài)耐壓、開態(tài)耐壓與漂移區(qū)長度Ld(μm)的關(guān)系,以及在漂移區(qū)長度Ld=9μm情況下關(guān)態(tài)耐壓、開態(tài)耐壓與漂移區(qū)注入劑量Nd(cm-2)的關(guān)系。其他參數(shù)為:n型體區(qū)注入劑量5e12 cm-2,Nsink注入劑量3e15 cm-2,P-buffer注入劑量1.5e13 cm-2,溝道長度3μm,柵極場板3μm。從仿真結(jié)果可以看出:pLDMOS的關(guān)態(tài)耐壓隨漂移區(qū)的增加而增大,隨漂移區(qū)的注入劑量的增大先增大后減小;開態(tài)耐壓隨著漂移區(qū)注入劑量的增大而降低,但是在一定范圍內(nèi)漂移區(qū)長度對其影響較小。總體上,pLDMOS的關(guān)態(tài)耐壓、開態(tài)耐壓都在160V以上,完全能夠滿足8~-100V工作電壓(108V耐壓)的要求。
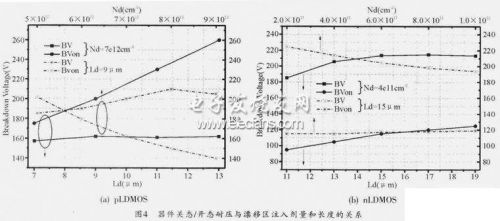
[page]
針對nLDMOS器件開態(tài)耐壓低的問題,有針對性地仿真了溝道長度、多晶硅柵場板長度及體區(qū)濃度對開態(tài)耐壓的影響。圖5(a)為nLDMOS的關(guān)態(tài)耐壓、開態(tài)耐壓及閾值與溝道長度(Lch)的關(guān)系。可以看出溝道長度對器件的開態(tài)耐壓和關(guān)態(tài)耐壓影響很小。閾值隨著溝道長度的增加而增加,這是由于采用橫向雙擴散形成溝道,所以隨著溝道長度增加,p型體區(qū)的濃度越來越大,閾值也就越來越大。圖5(b)為nLDMOS的關(guān)態(tài)耐壓、開態(tài)耐壓及閾值與多晶硅柵極場板長度(LPgate)的關(guān)系。在柵極場板較長時,其對閾值和關(guān)態(tài)耐壓影響很小,當(dāng)柵極場板縮短到多晶硅柵不能覆蓋溝道時,器件的開態(tài)耐壓大幅增加。這時閾值也迅速增加。雖然多晶硅柵不能完全覆蓋溝道,但是由于開態(tài)時nLDMOS的柵漏電壓差很大,所以仍然能夠在表面形成反型層溝道。因此,大幅減短柵極場板能有效提高器件的開態(tài)耐壓,但是同時也帶來了器件不能有效開啟的問題。圖5(c)為nLDMOS的關(guān)態(tài)耐壓、開態(tài)耐壓及閾值與體區(qū)注入劑量(Pbody)的關(guān)系。可以看出增加體區(qū)的注入劑量對器件的耐壓影響很小。但是隨著注入劑量的增加,體區(qū)濃度增加,所以閾值就增加,同時器件的開態(tài)耐壓也隨之增加。當(dāng)體區(qū)注入劑量達到5e14cm-2時,閾值增加緩慢,開態(tài)耐壓卻大幅增加,所以只能通過閾值上的犧牲來改善nLDMOS的開態(tài)擊穿耐壓。

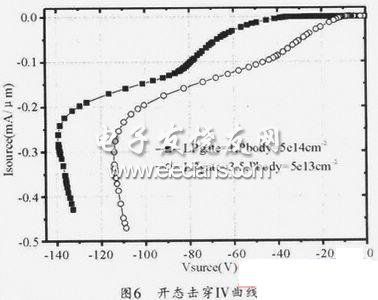
3 結(jié)束語
基于此電路結(jié)構(gòu)設(shè)計了滿足電路應(yīng)用需求的高壓器件。并對高壓LDMOS進行了優(yōu)化設(shè)計,尤其是高壓nLDMOS的開態(tài)耐壓。得到高壓nLDMOS的關(guān)態(tài)擊穿電壓215V,開態(tài)擊穿電壓140V,閾值電壓24V;高壓pLDMOS的關(guān)態(tài)擊穿電壓200V,開態(tài)擊穿電壓160V,閾值電壓-1V。




