中心議題:
- IGBT及其子器件的四種失效模式
解決方案:
- MOS柵擊穿失效模式
- IGBT——MOS閾值電壓漂移
- IGBT壽命期內有限次連續短路脈沖沖擊的累積損傷
- 靜電放電保護用高壓npn管的硅熔融
1、 引言
IGBT及其派生器件,例如:IGCT,是MOS和雙極集成的混合型半導體功率器件。因此,IGBT的失效模式,既有其子器件MOS和雙極的特有失效模式,還有混合型特有的失效模式。MOS是靜電極敏感器件,因此,IGBT也是靜電極敏感型器件,其子器件還應包括靜電放電(SED)防護器件。據報道,失效的半導體器件中,由靜電放電及相關原因引起的失效,占很大的比例。例如:汽車行業由于失效而要求退貨的器件中,其中由靜電放電引起的失效就占約30%。
本文通過案例和實驗,概述IGBT及其子器件的四種失效模式:
(1) MOS柵擊穿;
(2) IGBT——MOS閾值電壓漂移;
(3) IGBT壽命期內有限次連續短路脈沖沖擊的累積損傷;
(4) 靜電放電保護用高壓npn管的硅熔融。
2、 MOS柵擊穿
IGBT器件的剖面和等效電路見圖1。
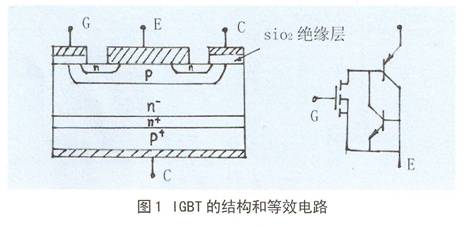
由圖1可見,IGBT是由一個MOS和一個npnp四層結構集成的器件。而MOS是金屬—氧化物—半導體場效應管的簡稱。其中,氧化物通常是硅襯底上氧化而生成的SIO2,有時還迭加其他的氧化物層,例如Si3N4,Al2O3。通常設計這層SiO2的厚度ts: 微電子系統:ts<1000A 電力電子系統:ts≥1000A。
SiO2,介質的擊穿電壓是1×1019V/m。那么,MOS柵極的擊穿電壓是100V左右。
人體產生的靜電強度U:濕度10-20%,U>18000V;濕度60-90%時,U≥1500V。
上述數據表明,不附加靜電保護的MOS管和MOS集成電路(IC),只要帶靜電的人體接觸它,MOS的絕緣柵就一定被擊穿。
案例:上世紀六十年代后期,某研究所研制的MOS管和MOS集成電路。不管是安裝在印刷電路板上還是存放在盒中的此種器件,都出現莫名其妙的失效。因此,給MOS一個綽號:摸死管。
如果這種“摸死”問題不解決,我國第一臺具有自主知識產權的MOS集成電路微型計算機就不可能在1969年誕生。經過一段時間的困惑,開始懷疑靜電放電的作用。為了驗證,準備了10支柵極無任何防護的MOS管,用晶體管特性測試儀重新測試合格后,即時將該器件再往自己身上摩擦一下再測特性,結果發現:100%柵擊穿!隨后,在MOS管的柵極一源極之間反并聯一個二極管,問題就基本解決。意外的結果:“摸死管”成了一句引以為戒的警語。該研究所內接觸和應用MOS管MOS-IC的同事,對靜電放電對器件的破壞性影響都有了深刻的體驗。
3、 IGBT——MOS閾值電壓漂移——一種可能隱藏的失效模式
MOS管的閾值電壓Vth的方程式:
式中,VSS=表面態閾值電壓,Vhh =本征閾值電壓,常數 ,
, (費米勢),N=硅襯底雜質濃度。
(費米勢),N=硅襯底雜質濃度。
[page]
圖2是柵電壓VG和柵電容CO的C—V曲線,曲線上的箭頭表時掃描方向。
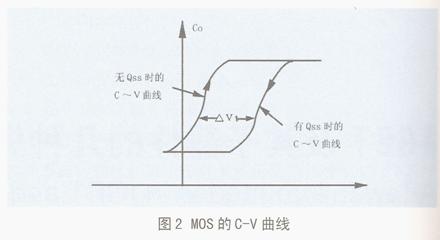
由圖2可見。C—V曲線是一條遲滯回路,該回路包絡的面積等于表面態電荷,QSS是由Si—SiO2界面缺陷和正電荷離子引起的。而且,Si—SiO2界面的QSS始終是正的。即VSS總是向VITH正向移動。這就決定了溝增強型MOS管和P溝數字集成電路容易實現。
為了減小QSS和防止SiO2——Si界面電荷交換與移動,引起閾值電壓漂移,采取了許多措施:
(1) 將<111>硅襯底換為<100>硅襯底,減小硅表面的非飽和鍵;
(2) 制備工藝中使用的石英器皿,氣體和化學試劑均提升純度級別,盡量減小Na離子的污染含量;
(3) 研發新的絕緣柵介質系列:
·Si3N4——Si,Si3N4——SiO2——Si;
·Al2O3——Si,Al2O3——SiO2——Si。
以上措施,對低壓微功耗的微電子的應用,已證明MOS與MOSIC是可靠的。但是對于電力電子應用的場合:高電壓,大電流和工作溫度范圍較寬。特別是,靜電放電電壓接近柵極擊穿電壓而又未穿柵極時,例如上文所示接近100V時,仍有隱憂:
(1) 較高柵電壓下,閾值電壓漂移 較大,圖3示出P溝硅柵MOS在高柵電壓下的。由圖3可見,柵電壓VG=40V時,
較大,圖3示出P溝硅柵MOS在高柵電壓下的。由圖3可見,柵電壓VG=40V時, =4V。
=4V。
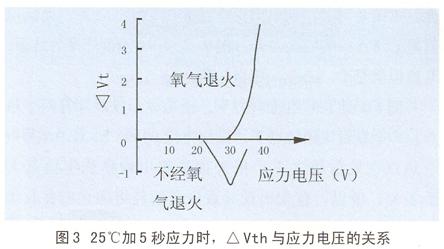
(2) PT—IGBT在高溫柵偏壓下閾值電壓漂移 。圖4給出PT—IGBT(IRG4BC20F)在(1)柵已射極Gge=20V,Vce=OV(HTGB)和(2)Vge=0V,Vce=0.8V(HTRB)在140℃,經過1200小時的應力試驗結果。由圖4中的HTGB曲線可見,柵偏置試驗開始后100小時內,
。圖4給出PT—IGBT(IRG4BC20F)在(1)柵已射極Gge=20V,Vce=OV(HTGB)和(2)Vge=0V,Vce=0.8V(HTRB)在140℃,經過1200小時的應力試驗結果。由圖4中的HTGB曲線可見,柵偏置試驗開始后100小時內, 時線性增加,隨后趨于穩定。
時線性增加,隨后趨于穩定。

(3) 電可擦只讀存貯器(electrically erasable read-only memory,簡稱EEROM)的存貯單元是氮化硅(Si3N4)—二氧化硅(SiO2)構成的雙層絕緣柵的MOS管,它利用柵極注入電荷來改變ROM存貯單元的狀態。
(4) MOS是一種單極,多數載流子器件,按半導體器件理論,它的抗輻射,主要是抗γ射線的能力應該比雙極、少數載流子器件強,但是,實際情況剛相反。這說明MOS的絕緣柵結構在輻射場下有較大的損傷和電荷交換。
(5) 以上4種情況說明,MOS閾值電壓漂移 在電力電子的應用條件,即高電壓(接近柵擊穿電壓)、大電流和高溫(接近pn結臨界溫度150℃)時,是一種導致器件和電路失效的潛在參數,似乎仍需系統考察和修訂老化條件。所以,將稱作是一種可能隱藏的失效模式。
在電力電子的應用條件,即高電壓(接近柵擊穿電壓)、大電流和高溫(接近pn結臨界溫度150℃)時,是一種導致器件和電路失效的潛在參數,似乎仍需系統考察和修訂老化條件。所以,將稱作是一種可能隱藏的失效模式。
[page]
4、 IGBT壽命期限內,有限次數短路脈沖沖擊的累積損傷失效
在壽命期限內,IGBT會遇到在短路、雪崩等惡劣條件下工作,它能承受短路脈沖沖擊的次數是有限的,并和相關條件有關。
4.1非穿通型(NPT)IGBT的魯棒性
NPT—IGBT的魯棒性見圖5,被測器件是SGW15N120。在540V 125℃時測試。X軸是耗散的能量。Y軸是器件直至損壞的短路周期次數。
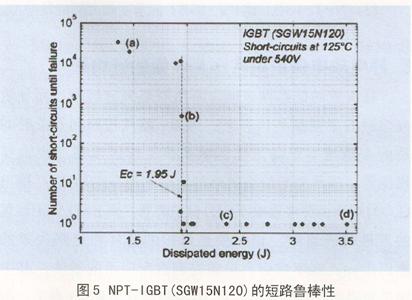
由圖5可見,在給定條件下,器件有一個臨界能量: EC=V·I·TSC=1.95J(焦耳)
式中,TSC是短路持續時間,
當E>EC時,第一次短路就使器件失效。
當E<EC時,大約要經歷104次短路以上,器件會因周期性的能量累積退化使它失效。
當E=EC時,器件失效模式不明確。當能量等于或稍等于EC時,器件關斷后,器件的拖尾電流,經過一段延遲時間td f ,將導致熱擊穿。這段延緩性失效時間為微秒級。
圖6給出不同短路續時間TSC,IGBT測量的短路電流波形。

由圖6可以看出:
(1) 緊隨器件關斷后,初始拖尾電流電平(lio)直至失效的延遲時間是由能量決定的,或者說由器件關斷后的溫度決定的。能量越大,拖尾電流電平也越高,失效的延遲時間則越短。例如,圖中給出的最大能量是Tsc=60us,這時,Tds趨向一個極小值。
(2) 當Tsc=33us時,屬于E<EC狀態,不發生延遲失效。當Tsc=35us,Tds=25us,開始出現熱擊穿。
4.2管殼溫度的影響
管殼溫度對臨界能量EC的影響最大,管殼溫度升高,EC就下降,測量SGW15N60的結果是:
溫度:25℃—>125℃; EC:0.81J—>0.62J
4.3集電極電壓的影響
集電極電壓升高,EC就下降:
VC:250V—>540V;EC:2.12J—>1.95J
[page]
4.4穿通型(PI)IGBT
PT—IGBT的短路失效特性和NPT—IGBT類似,但是,臨界能理值EC比NPT—IGBT低。例如:在125℃,短路電壓Vsc=400V時:
600V PT—IGBT(IRGP20u):EC=0.37J
600V NPT—IGBT(SGW15N60):EC=0.62J
4.5結果
(1)每次短路周期耗散的能量E小于由被測電路電壓Vce、短路持續時間Tsc和管殼溫度決定的臨界能量Ec時,IGBT可以連續承受104次以上短路沖擊才失效。
(2)在可比的條件下,當E>EC時,一次短路就失效。
(3)NPT—IGBT比PT—IGBT能承受較大的能量沖擊。
5、靜電放電保護用高壓NPN管的硅熔融
在失效的硅器件表面,常常觀察到硅熔融,而導致硅熔融的原因卻不只一個。例如:器件短路和開關時的瞬間大電流,正向工作區域或熱工作區出現二次擊穿損傷等到。因此要對靜電敏感的器件和電路的輸入/輸出(I/O)端增設靜電放電(ESD)保護裝置。而ESD保護裝置的器件的硅熔融,也是使被保護的器件和電路失效的原因之一。在本文引言中曾提到汽車應用的器件,其中原因失效要退貨的數量中,有30%的失效與ESD有關。由于I/O端的規范不同,需要及時對器件和電路進行再設計。同時,為了減少試驗成本,提高可靠性,需要采用計算機輔助設計技術(TCAD)。
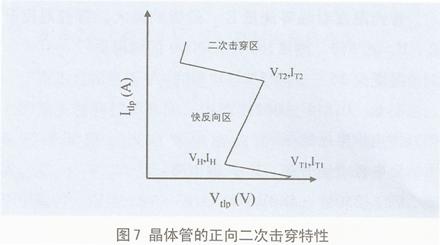
圖7是晶體管的正向擊穿特性,圖7中的VT·是器件的損傷點,其定義有以下三種設定:
(1) 器件的漏泄電流大于某一臨界值即定為器件失效。但它忽略了硅熔融和氧化層的擊穿;
(2) 器件出現強烈電壓崩潰的二次擊穿時定為器件失效,但有時器件達到大電流范圍也不出現二次擊穿。
(3) 當器件的載流子碰撞電離Gi等于肖克萊—里德—霍爾(Shockley—Read—Hall)復合率,同時,總電流隨電壓反向增加時定為器件失效。
為了驗證第(3)種假設,予測二次擊穿管點,用0.35um特征尺寸的功率集成電路工藝設計了ESD防護用的標準高壓NPN管,并將基極—發射極接地。
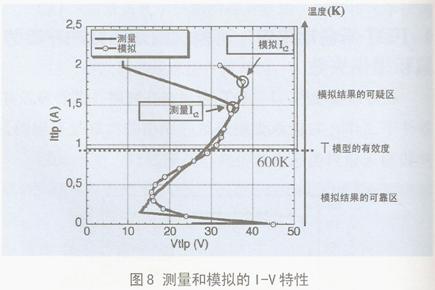
圖8是NPN管測量的和用(2)假定來模擬的I-V特性。由圖8可見,測量的損傷電流IT2=1.5A,而模擬值是1..8A,有較大誤差。
[page]
圖9是用(3)假設外推的結果。其模擬值是1.52A,相當一致。
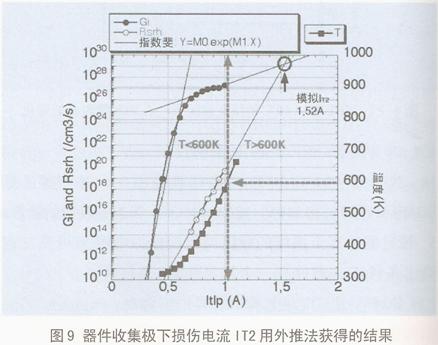
圖10是1A電流應力下,模擬顯示該器件有兩個熱點。一個在收集極觸點下,損傷電流IT2=1.52A;另一個熱點在發射極之下,用外推法算出的損傷電流遠大于2A。所以,首先出現導致失效的硅熔融點應在收集極。
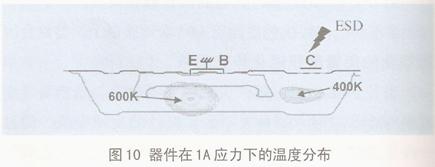
圖11是該器件失效照片。證明此結果。
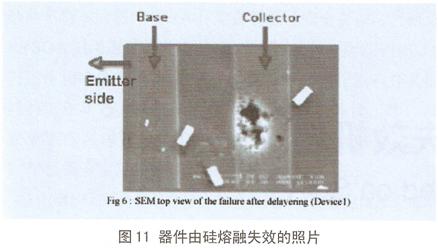
本案例說明:(1)ESD防護器件的失效也是實際器件和電路失效的一種模式。(2)防護用的NPN管的損傷點可以用TCAD獲得。





